
文章图片
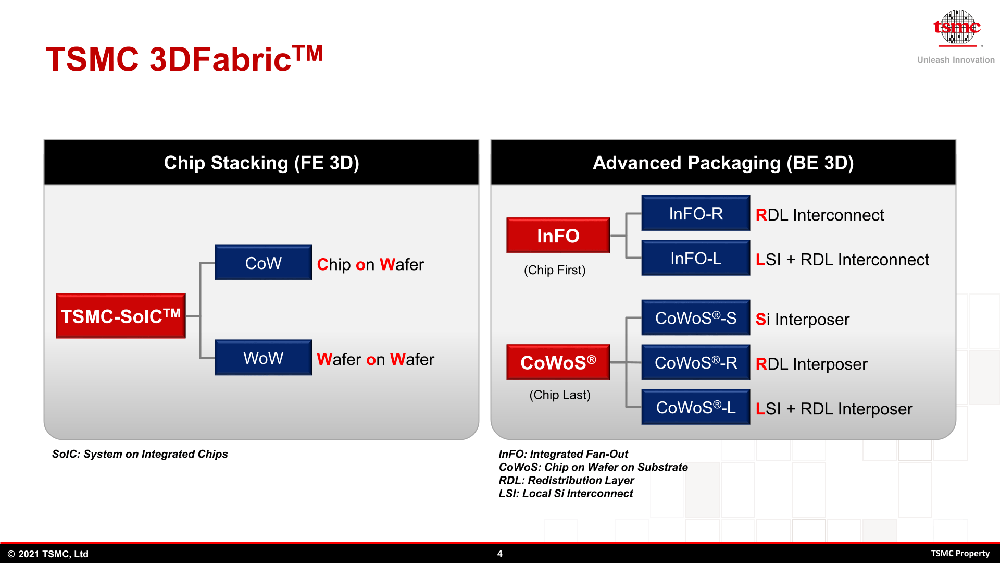
文章图片
众所周知 , 当芯片工艺提升 , 快要达到极限时 , 越来越多的厂商 , 就另想它法 , 来为摩尔定律续命了 。
比如芯片堆叠 , Chiplet技术等 , 通过几块芯片 , 整合成一块 , 最终在工艺不断的情况下 , 达到性能提升的目标 。
特别是国内 , 很多人都认为 , 芯片堆叠或Chiplet技术 , 是我们弯道超车的方向之一 , 能够挽救当前工艺暂时无法提升的中国芯 。
事实上 , 芯片堆叠也好 , Chiplet技术也好 , 其本质是3D封装技术 , 那么问题就来了 , 目前在3D封装这一块 , 究竟谁最厉害?谁的专利最多?
结果是很遗憾的 , 那就是国内的企业在先进3D封装这一块 , 还是落后的 , 所以大家认为的我们可以用芯片堆叠、Chiplet技术弯道超车 , 真不现实 , 因为别人比你更厉害 , 你怎么弯道上超车?
先给一个数据 , 这是2021年半导体厂们用于先进封装技术的资本支出 , 前5名分别是英特尔、台积电、日月光、三星、安可 。 这5大厂商 , 贡献了91%的资本支出 。
而国内的长电、通富贡献的资本支出约为9% , 还不及英特尔的三分之一 。 没有钱 , 哪来的先进技术?
再说先进技术这一块 , 台积电的CoWoS封装技术已发展到第五代 , 台积电已将自身的先进封装技术整合为了3DFabric技术平台 , 包含台积电前端的SoIC技术和后端CoWoS、InFO封装技术 。
而三星的先进封装技术 , 包括I-Cube、X-Cube、R-Cube和H-Cube四种方案 。 其中R-Cube和H-Cube是2.5D封装技术 , 而X-Cube是3D封装技术 。
英特尔在2014年就有了2.5D封装技术EMIB , 后来在2018年又发布了Foveros 3D封装技术 , 可以实现芯片的各种堆叠方案 。 2019年 , 英特尔又发布了新的三大先进封装技术 , 分别为Co-EMIB、ODI和MDIO 。
从目前行业情况来看 , 英特尔、三星、台积电这三家芯片制造巨头 , 才是先进封装的第一梯队 , 而封测厂其实已经慢慢落后为第二梯队了 。
【芯片|认清现实,芯片堆叠技术我们并不先进,救不了中国芯】所以目前在芯片堆叠、Chiplet等技术上 , 也是晶圆厂们在领先 , 毕竟制造处于更前端 , 至于封测已经难以具备前端优势了 , 落后于第一梯队了 。
而芯片堆叠、什么Chiplet技术 , 其实就是拼的3D封装 , 在这种情况下 , 你觉得我们能弯道超车么?
所以请大家现实点 , 认清自己的差距 , 努力去追赶 , 不要总想着某一项新技术拿出来弯道超车 。 在基础本来就弱于别人的情况下 , 基本是没弯道超车的可能 , 你觉得呢?
- 芯片|苹果要求喷墨打印密封iPhone 14 Pro灵动岛开孔
- it芯片|都2022年, 128GB早就落后了,256GB只能说勉强够用!
- 芯片|怎么让图片流动?建议收藏这些方法
- 华为芯片归零, 手机业务收缩,但新的“反击战”已经打响!
- |4nm芯片+167g,从4999元跌至3399元,三星“小钢炮”旗舰加速清仓
- 移民|小芯片标准更有利于中国芯片,缩短与海外的芯片技术差距
- 显示器|都有独显芯片加持,iQOONeo7竞速版对比荣耀80GT,选哪款更好?
- 芯片|两种常用的呼气酒精检测传感器
- 随着现在加入羊群的人数不断增加|抢不到血氧仪?那就diy:只需一个手机、芯片和传感器
- 芯片|美升级对华芯片封锁之际,英媒:美铜墙铁壁下,中国芯出现新希望
